Multiple patterning
View on WikipediaThis article may be too technical for most readers to understand. (December 2022) |
Multiple patterning (or multi-patterning) is a class of technologies for manufacturing integrated circuits (ICs), developed for photolithography to enhance the feature density. It is expected to be necessary for the 10 nm and 7 nm node semiconductor processes and beyond. The premise is that a single lithographic exposure may not be enough to provide sufficient resolution. Hence additional exposures would be needed, or else positioning patterns using etched feature sidewalls (using spacers) would be necessary.

Top: Splitting of features into groups (3 shown here), each patterned by a different mask
Center: Use of a spacer to generate additional separate features in the gaps
Bottom: Use of an opposite polarity feature to cut (small break) pre-existing features
Even with single exposure having sufficient resolution, extra masks have been implemented for better patterning quality such as by Intel for line-cutting at its 45nm node[1] or TSMC at its 28nm node.[2] Even for electron-beam lithography, single exposure appears insufficient at ~10 nm half-pitch, hence requiring double patterning.[3][4]
Double patterning lithography was first demonstrated in 1983 by D. C. Flanders and N. N. Efremow.[5] Since then several double patterning techniques have been developed such as self alignment double patterning (SADP) and a litho-only approach to double patterning.[6][7]
Pitch double-patterning was pioneered by Gurtej Singh Sandhu of Micron Technology during the 2000s, leading to the development of 30-nm class NAND flash memory. Multi-patterning has since been widely adopted by NAND flash and random-access memory manufacturers worldwide.[8][9]
Situations requiring multiple patterning
[edit]There are a number of situations which lead to multiple patterning being required.
Sub-resolution pitch
[edit]
The most obvious case requiring multiple patterning is when the feature pitch is below the resolution limit of the optical projection system. For a system with numerical aperture NA and wavelength λ, any pitch below 0.5 λ/NA would not be resolvable in a single wafer exposure. The resolution limit may also originate from stochastic effects, as in the case of EUV. Consequently, 20 nm linewidth still requires EUV double patterning, due to larger defectivity at larger pitches.[10]
Two-dimensional pattern rounding
[edit]
It is well-established that dense two-dimensional patterns, which are formed from the interference of two or three beams along one direction, as in quadrupole or QUASAR illumination, are subject to significant rounding, particularly at bends and corners.[11][12][13] The corner rounding radius is larger than the minimum pitch (~0.7 λ/NA).[14] This also contributes to hot spots for feature sizes of ~0.4 λ/NA or smaller.[15] For this reason, it is advantageous to first define line patterns, then cut segments from such lines accordingly.[16] This requires additional exposures. The cut shapes themselves may also be round, which requires tight placement accuracy.[16][17][18]
Line tip vs. linewidth tradeoff
[edit]The rounding of line tips naturally leads to a tradeoff between shrinking the line width (i.e., the width of the line tip) and shrinking the gap between opposite facing tips. As the line width shrinks, the tip radius shrinks. When the line tip is already less than the point spread function (k1~0.6–0.7), the line tip naturally pulls back,[19] increasing the gap between opposite facing tips. The point spread function likewise limits the resolvable distance between the centers of the line tips (modeled as circles). This leads in turn to a tradeoff between reducing cell width and reducing cell height. The tradeoff is avoided by adding a cut/trim mask (see discussion below).[20] Hence, for the EUV-targeted 7nm node, with an 18 nm metal linewidth (k1=0.44 for λ=13.5 nm, NA=0.33), the line tip gap of less than 25 nm (k1=0.61) entails EUV single patterning is not sufficient; a second cut exposure is necessary.
Different parts of layout requiring different illuminations
[edit]
When patterns include feature sizes near the resolution limit, it is common that different arrangements of such features will require specific illuminations for them to be printed.[21]
The most basic example is horizontal dense lines vs. vertical lines (half-pitch < 0.35 λ/NA), where the former requires a North-South dipole illumination while the latter requires an East-West dipole illumination. If both types are used (also known as cross-quadrupole C-Quad), the inappropriate dipole degrades the image of the respective line orientation.[22] Larger pitches up to λ/NA can have both horizontal and vertical lines accommodated by quadrupole or QUASAR illumination, but diagonally spaced features and elbow features are degraded.[23][24]
In DRAM, the array and periphery are exposed at different illumination conditions. For example, the array could be exposed with dipole illumination while the periphery could use annular illumination.[25] This situation applies to any set of patterns (half-pitch < 0.5 λ/NA) with different pitches or different feature arrangements, e.g., rectangular arrays vs. staggered arrays.[26][27][28][29] Any of the individual patterns is resolvable, but a single illumination cannot be used simultaneously for all of them. A minimum pitch may require an illumination that is detrimental to twice the minimum pitch with defocus.[30][31]
The inclusion of both isolated and dense features is a well-known instance of multi-pitch patterning. Subresolution assist features (SRAFs) have been designed to enable the patterning of isolated features when using illumination tailored for the dense features. However, not all pitch ranges can be covered. In particular, semi-dense features may not be easy to include.[32][33]
Specific example: hole arrays
[edit]
For the specific case of hole arrays (minimum half-pitch < 0.6 λ/NA), three well-known cases require three entirely different illuminations. A regular array generally requires Quasar illumination, while the same array rotated 45 degrees results in a checkerboard array that requires C-quad illumination.[29] Different from both cases, an array with close to triangular or hexagonal symmetry requires hexapole illumination.[34]
Multi-pitch patterns
[edit]

Sometimes a feature pattern inherently contains more than one pitch, and furthermore, these pitches are incompatible to the extent that no illumination can simultaneously image both pitches satisfactorily. A common example, again from DRAM, is the brick pattern defining the active regions of the array.[35][36] In addition to the narrow pitch of the active regions, there is also the pitch between the active region separations or breaks, which is different from that of the narrow pitch in the same direction. When the narrow pitch is < λ/NA (but still > 0.5 λ/NA), it cannot be imaged simultaneously with the double pitch due to the focus limitations of the latter. Selective etching, along with SADP or SAQP (to be described below), is the current best approach to achieve the simultaneous patterning of both pitches.[37]
Small deviations from 2-beam interference
[edit]A two-beam interference pattern (half-pitch <0.5 λ/NA) forms a set of regularly spaced lines. Breaks in such lines, e.g., brick patterns, are deviations from the interference pattern. Such breaks generally do not dominate the pattern, and are thus small deviations. These deviations are insufficient to completely offset the constructive or destructive interference of the underlying regular line pattern; sidelobes often result.[38][39] Line end gaps are easily bridged under dipole illumination.[40] Another mask exposure (usually referred as a cut mask) is therefore necessary to break the line pattern more robustly.
Line cutting
[edit]
The earliest implementation of multiple patterning involved line cutting. This first occurred for Intel's 45nm node, for 160 nm gate pitch.[41] The use of a second mask to cut lines defined by a first mask does not help increase feature density directly. Instead it allows definition of features, e.g., brick patterns, which are based on lines spaced at a minimum pitch, in particular, when the lines are near the resolution limit and are generated by the two-beam interference mentioned above. The two-beam interference still dominates the diffraction pattern.[38] In fact, in the absence of a separate cut exposure, the gap between the ends of the minimum pitch lines will be prohibitively large.[42][43] This is due to rounding resulting from reduced spatial frequencies.[44]
The line cut shapes themselves are subject to rounding; this rounding can be minimized with optimized illumination,[45] but cannot be eliminated completely.
When applying the second mask to cut lines, the overlay relative to the first mask needs to be considered; otherwise, edge placement errors (EPE) may result. If the line pitch is already near the resolution limit, the cut pattern itself may have imaging difficulty, from reduced dose or focus window. EUV stochastic variability causes random shaping of the cuts.[46] In this case, more than one cut mask would have to be used, or else the cut has to extend over more than one line. Self-aligned line cutting (to be discussed below) may be a preferred option.
Pitch splitting
[edit]



The earliest form of multiple patterning involved simply dividing a pattern into two or three parts, each of which may be processed conventionally, with the entire pattern combined at the end in the final layer. This is sometimes called pitch splitting, since two features separated by one pitch cannot be imaged, so only skipped features can be imaged at once. It is also named more directly as "LELE" (Litho-Etch-Litho-Etch). This approach has been used for the 20 nm and 14 nm nodes. The additional cost of extra exposures was tolerated since only a few critical layers would need them. A more serious concern was the effect of feature-to-feature positioning errors (overlay). Consequently, the self-aligned sidewall imaging approach (described below) has succeeded this approach.
A "brute force" approach for patterning trenches involves a sequence of (at least) two separate exposures and etchings of independent patterns into the same layer. For each exposure, a different photoresist coating is required. When the sequence is completed, the pattern is a composite of the previously etched subpatterns. By interleaving the subpatterns, the pattern density can theoretically be increased indefinitely, the half-pitch being inversely proportional to the number of subpatterns used. For example, a 25 nm half-pitch pattern can be generated from interleaving two 50 nm half-pitch patterns, three 75 nm half-pitch patterns, or four 100 nm half-pitch patterns. The feature size reduction will most likely require the assistance of techniques such as chemical shrinks, thermal reflow, or shrink assist films. This composite pattern can then be transferred down into the final layer.
This is best described by considering a process example. A first exposure of photoresist is transferred to an underlying hardmask layer. After the photoresist is removed following the hardmask pattern transfer, a second layer of photoresist is coated onto the sample and this layer undergoes a second exposure, imaging features in between the features patterned in the hardmask layer. The surface pattern is made up of photoresist features edged between mask features, which can be transferred into the final layer underneath. This allows a doubling of feature density.
For advanced nodes, both EUV and DUV may require splitting bidirectional layouts into more than two parts, resulting in triple and quadruple patterning, respectively.[47]
Sometimes, it is necessary to "stitch" two separately printed features into a single feature.[48][49][50] This form of double patterning was used down to ~15nm DRAM and possibly beyond.[51]
A variation on this approach which eliminates the first hardmask etch is resist freezing,[52] which allows a second resist coating over the first developed resist layer. JSR has demonstrated 32 nm lines and spaces using this method,[53] where the freezing is accomplished by surface hardening of the first resist layer.
In recent years, the scope of the term 'pitch splitting' has gradually been expanded to include techniques involving sidewall spacers.
Sidewall image transfer
[edit]
In spacer patterning, a spacer is a film layer formed on the sidewall of a pre-patterned feature. A spacer is formed by deposition or reaction of the film on the previous pattern, followed by etching to remove all the film material on the horizontal surfaces, leaving only the material on the sidewalls. By removing the original patterned feature, only the spacer is left. However, since there are two spacers for every line, the line density has now doubled. This is commonly referred to as self-aligned double patterning (SADP). The spacer technique is applicable for defining narrow gates at half the original lithographic pitch, for example.
As pitch splitting has become more difficult due to possible differences in feature positions between different exposed parts, sidewall image transfer (SIT) has become more recognized as the necessary approach. The SIT approach typically requires a spacer layer to be formed on an etched feature's sidewall. If this spacer corresponds to a conducting feature, then ultimately it must be cut at no less than two locations to separate the feature into two or more conducting lines as typically expected. On the other hand, if the spacer corresponds to a dielectric feature, cutting would not be necessary. The prediction of how many cuts would be needed for advanced logic patterns has been a large technical challenge. Many approaches for spacer patterning have been published (some listed below), all targeting the improved management (and reduction) of the cuts.
As spacer materials are commonly hardmask materials, their post-etch pattern quality tends to be superior compared to photoresist profiles after etch, which are generally plagued by line edge roughness.[54]
The main issues with the spacer approach are whether the spacers can stay in place after the material to which they are attached is removed, whether the spacer profile is acceptable, and whether the underlying material is attacked by the etch removing the material attached to the spacer. Pattern transfer is complicated by the situation where removal of the material adjacent to the spacers also removes a little of the underlying material. This results in higher topography on one side of the spacer than the other.[55] Any misalignment of masks or excursion in pre-patterned feature critical dimension (CD) will cause the pitch between features to alternate, a phenomenon known as pitch walking.[56]
The positioning of the spacer also depends on the pattern to which the spacer is attached. If the pattern is too wide or too narrow, the spacer position is affected. However, this would not be a concern for critical memory feature fabrication processes which are self-aligned.
When SADP is repeated, an additional halving of the pitch is achieved. This is often referred to as self-aligned quadruple patterning (SAQP). With 76 nm being the expected minimum pitch for a single immersion lithography exposure,[57] 19 nm pitch is now accessible with SAQP.
Self-aligned contact/via patterning
[edit]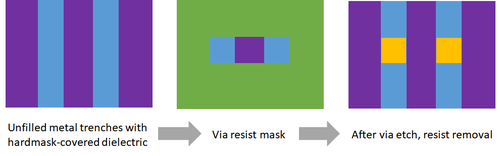
Self-aligned contact and via patterning is an established method for patterning multiple contacts or vias from a single lithographic feature. It makes use of the intersection of an enlarged feature resist mask and underlying trenches which are surrounded by a pre-patterned hardmask layer. This technique is used in DRAM cells[58] and is also used for advanced logic to avoid multiple exposures of pitch-splitting contacts and vias.[59][60][61]
Since 32 nm node, Intel has applied the above-mentioned self-aligned via approach, which allows two vias separated by a small enough pitch (112.5 nm for Intel 32 nm metal)[62] to be patterned with one resist opening instead of two separate ones.[61] If the vias were separated by less than the single exposure pitch resolution limit, the minimum required number of masks would be reduced, as two separate masks for the originally separated via pair can now be replaced by a single mask for the same pair.
Spacer-is-dielectric (SID) SADP
[edit]

In self-aligned double patterning (SADP), the number of cut/block masks may be reduced or even eliminated in dense patches when the spacer is used to directly pattern inter-metal dielectric instead of metal features.[63] The reason is the cut/block locations in the core/mandrel features are already patterned in the first mask. There are secondary features which emerge from the gaps between spacers after further patterning. The edge between a secondary feature and the spacer is self-aligned with the neighboring core feature.
2D SID spacer patterning
[edit]The use of SID may be applied to 2D arrays, by iteratively adding features equidistant from the previously present features, doubling the density with each iteration.[64][65] Cuts not requiring tight positioning may be made on this spacer-generated grid.[66]
Triangular spacer (honeycomb structure) patterning
[edit]
Samsung recently demonstrated DRAM patterning using a honeycomb structure (HCS) suitable for 20 nm and beyond.[67] Each iteration of spacer patterning triples the density, effectively reducing 2D pitch by a factor of sqrt(3). This is particularly useful for DRAM since the capacitor layer can be fit to a honeycomb structure, making its patterning simpler.
Self-aligned quadruple patterning (SAQP)
[edit]
SADP may be applied twice in a row to achieve an effective pitch quartering. This is also known as self-aligned quadruple patterning (SAQP). With SAQP, the primary feature critical dimension (CD), as well as the spacing between such features, are each defined by either the first or second spacer.
It is preferred to have the second spacer define non-conducting features[68] for more flexible cutting or trimming options.
SAQP has advantages in two-dimensional 28 nm pitch routing (followed by two selective etch cut/trim steps), compared to EUV, due to the illumination limitations of the latter.[69]
Multi-Spacer Pitch Reduction
[edit]Iterations of deposition followed by etching or controlled etchback of multilayers can result in substantial pitch reduction beyond SAQP.[70] The number of layers determines the degree of pitch reduction.
Directed self-assembly (DSA)
[edit]
The number of masks used for sidewall spacer patterning may be reduced with the use of directed self-assembly (DSA) due to the provision of gridded cuts all at once within a printed area, which can then be selected with a final exposure.[71][66] Alternatively, the cut pattern itself may be generated as a DSA step.[72] Likewise, a split via layout may be recombined in pairs.[73]
Much progress had been reported on the use of PMMA-PS block copolymers to define sub-20 nm patterns by means of self-assembly, guided by surface topography (graphoepitaxy) and/or surface chemical patterning (chemoepitaxy).[74] The key benefit is the relatively simple processing, compared to multiple exposures or multiple depositions and etching. The main drawback of this technique is the relatively limited range of feature sizes and duty cycles for a given process formulation. Typical applications have been regular lines and spaces as well as arrays of closely packed holes or cylinders.[75] However, random, aperiodic patterns may also be generated using carefully defined guiding patterns.[76]
The line edge roughness in block copolymer patterns is strongly dependent on the interface tension between the two phases, which in turn, depends on the Flory "chi" (χ) parameter.[77] A higher value of χ is preferred for reduced roughness; the interfacial width between domains is equal to 2a(6χ)−1/2, where a is the statistical polymer chain length.[78] Moreover, χN > 10.5 is required for sufficient phase segregation, where N is the degree of polymerization (number of monomer repeats in the chain). On the other hand, the half-pitch is equal to 2(3/π2)1/3aN2/3χ1/6. The fluctuations of the pattern widths are actually only weakly (square root) dependent on the logarithm of the half-pitch, so they become more significant relative to smaller half-pitches.
DSA has not yet been implemented in manufacturing, due to defect concerns, where a feature does not appear as expected by the guided self-assembly.[79] However, there has been some progress in understanding ways to reduce defectivity for sub-10 nm half-pitch line patterns.[80]
At IWAPS 2024, Fudan University showed large-area, defect-free arrays using a quadruple-hole patterning technique based on DSA, which potentially significantly reduces the number of masks used in multipatterning.[81][82]
Other multi-patterning techniques
[edit]There have been numerous concerns that multiple patterning diminishes or even reverses the node-to-node cost reduction expected with Moore's Law. EUV is more expensive than three 193i exposures (i.e., LELELE), considering the throughput.[83] Moreover, EUV is more liable to print smaller mask defects not resolvable by 193i.[84] Some aspects of other considered multi-patterning techniques are discussed below.
Self-aligned triple patterning (SATP)
[edit]
Self-aligned triple patterning has been considered as a promising successor to SADP, due to its introduction of a second spacer offering additional 2D patterning flexibility and higher density.[85][86] A total of two masks (mandrel and trim) is sufficient for this approach.[87] The only added cost relative to SADP is that of depositing and etching the second spacer. The main disadvantage of SATP succeeding SADP is that it would only be usable for one node. For this reason, self-aligned quadruple patterning (SAQP) is more often considered. On the other hand, the conventional SID SADP flow may be extended quite naturally to triple patterning, with the second mask dividing the gap into two features.[88]
Tilted ion implantation
[edit]
Tilted ion implantation was proposed in 2016 by the University of Berkeley as an alternative method of achieving the same result as spacer patterning.[89] Instead of core or mandrel patterns supporting deposited spacers, an ion masking layer pattern shields an underlying layer from being damaged by ion implantation, which leads to being etched away in a subsequent process. The process requires the use of angled ion beams which penetrate to just the right depth, so as not to damage already processed layers underneath. Also, the ion masking layer must behave ideally, i.e., blocking all ions from passing through, while also not reflecting off the sidewall. The latter phenomenon would be detrimental and defeat the purpose of the ion masking approach. Trenches as small as 9 nm have been achieved with this approach, using 15 keV Ar+ ion implantation at 15-degree angles into a 10 nm thermal SiO2 masking layer. A fundamental aspect of this approach is the correlation between damage width and damage pitch; both widen at the same time for fixed ion mask height and ion beam angle.
Complementary polarity exposures
[edit]The method of complementary exposures[90] is another way of reducing mask exposures for multiple patterning. Instead of multiple mask exposures for individual vias, cuts or blocks, two exposures of opposing or complementary polarity are used, so that one exposure removes interior portions of the previous exposure pattern. The overlapped regions of two polygons of opposite polarity do not print, while the non-overlapped regions define locations that print according to the polarity. Neither exposure patterns the target features directly. This approach was also implemented by IMEC as two "keep" masks for the M0A layer in their 7nm SRAM cell.[91]
Self-aligned blocking or cutting
[edit]
Self-aligned blocking or cutting is currently being targeted for use with SAQP for sub-30 nm pitches.[92] The lines to be cut are divided into two materials, which can be etched selectively. One cut mask only cuts every other line made of one material, while the other cut mask cuts the remaining lines made of the other material. This technique has the advantage of patterning double pitch features over lines at the minimum pitch, without edge placement errors.[37] Cut-friendly layouts are processed with the same minimum number of masks (3), regardless of using DUV or EUV wavelength.[93]

EUV multiple patterning possibilities
[edit]
Although EUV has been projected to be the next-generation lithography of choice, it could still require more than one lithographic exposure, due to the foreseen need to first print a series of lines and then cut them; a single EUV exposure pattern has difficulty with line end-to-end spacing control.[12] In addition, the line end placement is significantly impacted by photon shot noise.
The existing 0.33 NA EUV tools are challenged below 16 nm half-pitch resolution.[94] Tip-to-tip gaps are problematic for 16 nm dimensions.[95] Consequently, EUV 2D patterning is limited to >32 nm pitch.[94] Recent studies of optimizing the EUV mask features and the illumination shape simultaneously have indicated that different patterns in the same metal layer could require different illuminations.[96][97][98][99][100] On the other hand, a single exposure only offers a single illumination.
For example, in a cross-pitch source-mask optimization for 7nm node, for 40-48 nm pitch and 32 nm pitch, the quality as determined by the normalized image log slope was insufficient (NILS<2), while only 36 nm pitch was barely satisfactory for bidirectional single exposure.[13]
The underlying situation is that EUV patterns may be split according to different illuminations for different pitches, or different pattern types (e.g., staggered arrays vs. regular arrays).[96] This could apply to line-cutting patterns as well as contact/via layers. It is also likely more than one cut would be needed, even for EUV.[101]
At the 2016 EUVL Workshop, ASML reported that the 0.33 NA NXE EUV tools would not be capable of standard single exposure patterning for the 11-13 nm half-pitch expected at the 5 nm node.[102] A higher NA of 0.55 would allow single exposure EUV patterning of fields which are half the 26 mm x 33 mm standard field size.[102] However, some products, such as NVIDIA's Pascal Tesla P100,[103] will be bisected by the half-field size, and therefore require stitching of two separate exposures.[104] In any case, two half-field scans consume twice as much acceleration/deceleration overhead as a single full-field scan.[102][105]
Stochastic defects, including edge placement error, also entail double (or higher) patterning for contacts/vias with center-to-center distance of 40 nm or less.[106][107]
Multipatterning implementations
[edit]
Memory patterns are already patterned by quadruple patterning for NAND[108] and crossed quadruple/double patterning for DRAM.[109] These patterning techniques are self-aligned and do not require custom cutting or trim masks. For 2x-nm DRAM and flash, double patterning techniques should be sufficient.
Current EUV throughput is still more than 3x slower than 193 nm immersion lithography, thus allowing the latter to be extended by multiple patterning. Furthermore, the lack of an EUV pellicle is also prohibitive.
As of 2016, Intel was using SADP for its 10 nm node;[110] however, as of 2017, the 36 nm minimum metal pitch is now being achieved by SAQP.[111] Intel is using triple patterning for some critical layers at its 14 nm node,[112] which is the LELELE approach.[113] Triple patterning is already demonstrated in 10 nm tapeout,[114] and is already an integral part of Samsung's 10 nm process.[115] TSMC is deploying 7 nm in 2017 with multiple patterning;[116] specifically, pitch-splitting,[117] down to 40 nm pitch.[118] Beyond the 5 nm node, multiple patterning, even with EUV assistance, would be economically challenging, since the departure from EUV single exposure would drive up the cost even higher. However, at least down to 12 nm half-pitch, LELE followed by SADP (SID) appears to be a promising approach, using only two masks, and also using the most mature double patterning techniques, LELE and SADP.[119]
Patterning costs
[edit]
| Patterning Method | Normalized Wafer Cost[120] |
|---|---|
| 193i SE | 1 |
| 193i LELE | 2.5 |
| 193i LELELE | 3.5 |
| 193i SADP | 2 |
| 193i SAQP | 3 |
| EUV SE | 4 |
| EUV SADP | 6 |
Compared to 193i SADP, EUV SADP cost is dominated by the EUV tool exposure, while the 193i SAQP cost difference is from the added depositions and etches. The processing cost and yield loss at a lithographic tool is expected to be highest in the whole integrated process flow due to the need to move the wafer to specific locations at high speed. EUV further suffers from the shot noise limit, which forces the dose to increase going for successive nodes.[121] On the other hand, depositions and etches process entire wafers at once, without the need for wafer stage motion in the process chamber. In fact, multiple layers may be added under the resist layer for anti-reflection or etch hard-mask purposes, just for conventional single exposure.
Published silicon demonstrations
[edit]| Pitch | Patterning Scheme | # Masks | Demonstrated by | Reference |
|---|---|---|---|---|
| 64 nm | LELE | 2 | IBM/Toshiba/Renesas | 2011 IITC |
| 56 nm | LELE | 2 | STMicroelectronics/IBM/Toshiba | Microel. Eng. 107, 138 (2013) |
| 48 nm | SADP + block mask | 2 | IBM/Samsung/GlobalFoundries | 2013 IITC |
| 40 nm | SADP + pitch-divided cut grid + cut selection pattern | 3 | Tela/Canon/TEL/Sequoia | Proc. SPIE 8683, 868305 (2013) |
| 40 nm | SADP + self-aligned block (LELE) | 3 | TEL | Proc. SPIE 10149, 101490O (2017) |
Leading-edge logic/ASIC multi-patterning practices
[edit]
| Company | Logic Process | Minimum Metal Pitch (MMP) | MMP Patterning Technique | Production Start |
|---|---|---|---|---|
| Intel | 14nm | 52 nm[122] | SADP + cut[122] | 2014[122] |
| Intel | 10nm | 36 nm[123] | SAQP + SAQP + LELE[123][124] | 2019 |
| TSMC | 7FF | 40 nm[118] | SADP + cut[125] | early 2017[126] |
| Samsung | 8LPP; continued to 7LPP[127][128] | 44 nm[129] | LELELELE[129] | end of 2018 |
Even with the introduction of EUV technology in some cases, multiple patterning has continued to be implemented in the majority of layers being produced. For example, quadruple patterning continues to be used for 7nm by Samsung.[127] TSMC's 7nm+ process also makes use of EUV in a multi-patterning context.[130] Only a few layers are affected anyway;[131] many remain conventional multi-patterning.
Mask costs
[edit]The mask cost strongly benefits from the use of multiple patterning. The EUV single exposure mask has smaller features which take much longer to write than the immersion mask. Even though mask features are 4x larger than wafer features, the number of shots is exponentially increased for much smaller features. Furthermore, the sub-100 nm features on the mask are also much harder to pattern, with absorber heights ≈70 nm.[132]
Wafer productivity
[edit]| Tool | EUV | EUV | Immersion | Immersion |
|---|---|---|---|---|
| WPH (wafers per hour) | 85 | 85 | 275 | 275 |
| # tools | 6 | 6 | 24[133] | 24 |
| uptime | 70% | 70% | 90% | 90% |
| # passes | 1 | 2 | 2 | 4 |
| WPM (wafers per month) | 257,040 | 128,520 | 2,138,400 | 1,069,200 |
| normalized WPM | 1 | 0.5 | 8 | 4 |
Note: WPM = WPH * # tools * uptime / # passes * 24 hrs/day * 30 days/month. Normalized WPM = WPM/(WPM for EUV 1 pass)
Multiple patterning with immersion scanners can be expected to have higher wafer productivity than EUV, even with as many as 4 passes per layer, due to faster wafer exposure throughput (WPH), a larger number of tools being available, and higher uptime.
Multiple patterning specific issues
[edit]
| Issue | LELE | LELELE | SID SADP | SAQP |
|---|---|---|---|---|
| Overlay | between 1st and 2nd exposures, especially where stitching | among all three exposures, especially where stitching | between core and cut exposures | between core and cut exposures |
| Exposed feature width | (1) 1st exposure (2) 2nd exposure | (1) 1st exposure (2) 2nd exposure (3) 3rd exposure | core feature | (1) core feature (2) cut shape |
| Feature slimming target width | 1/4 exposure pitch | 1/6 exposure pitch | 1/4 core pitch | 1/8 core pitch |
| Spacer width | N/A | N/A | 1 spacer | (1) 1st spacer (2) 2nd spacer |
Multiple patterning entails the use of many processing steps to form a patterned layer, where conventionally only one lithographic exposure, one deposition sequence and one etch sequence would be sufficient. Consequently, there are more sources of variations and possible yield loss in multiple patterning. Where more than one exposure is involved, e.g., LELE or cut exposures for SAQP, the alignment between the exposures must be sufficiently tight. Current overlay capabilities are ≈0.6 nm for exposures of equal density (e.g., LELE) and ≈2.0 nm for dense lines vs. cuts/vias (e.g., SADP or SAQP) on dedicated or matched tools.[134] In addition, each exposure must still meet specified width targets. Where spacers are involved, the width of the spacer is dependent on the initial deposition as well as the subsequent etching duration. Where more than one spacer is involved, each spacer may introduce its own width variation. Cut location overlay error can also distort line ends (leading to arcing) or infringe on an adjacent line.[16][17][18]
Mixed patterning methods
[edit]Multiple patterning is evolving toward a combination of multiple exposures, spacer patterning, and/or EUV. Especially with tip-to-tip scaling being difficult in a single exposure on current EUV tools,[12] a line-cutting approach may be necessary. IMEC reported that double patterning is becoming a requirement for EUV.[135]
| Grid definition | 1st Cut Exposure | 2nd Cut Exposure |
|---|---|---|
| SADP/SAQP | 1st Self-Aligned Block Mask | 2nd Self-Aligned Block Mask |
| SADP/SAQP | Cut grid[136][137][138][139] | Cut selection pattern[136][137][138][139] |
| EUV exposure | 1st Self-Aligned Block Mask | 2nd Self-Aligned Block Mask |
| SAQP | 1st overlaid spacer grid[140][141] | 2nd overlaid spacer grid [140][141][90][142] |

For line patterning, SADP/SAQP could have the advantage over the EUV exposure, due to cost and maturity of the former approach and stochastic missing or bridging feature issues of the latter.[143] For grid location patterning, a single DUV exposure following grid formation also has the cost and maturity advantages (e.g., immersion lithography may not even be necessary for the spacer patterning in some cases) and no stochastic concerns associated with EUV. Grid location selection has an advantage over direct point cutting because the latter is sensitive to overlay and stochastic edge placement errors, which may distort the line ends.[16][17] Vias located at staggered grid locations are also expected for routing and patterning convenience.[144][145]

Self-aligned litho-etch-litho-etch (SALELE) is a hybrid SADP/LELE technique whose implementation has started in 7nm[146] and continued use in 5nm.[147]
Multipatterning productivity improvements
[edit]Since 2017, several publications have indicated ways to improve multipatterning productivity. Self-aligned blocking allows blocking or cutting patterns to cross adjacent lines.[148] Cut redistribution allows distances between cuts to be adjusted to minimize the number of cut masks.[149][150] These techniques may also be combined with self-aligned vias, described earlier.[151]
The use of a via grid defined by intersecting diagonal lines can simplify patterning of both metal and via layers.[152][153]
Tip-to-tip distance relaxation can significantly reduce the number of masks needed for multipatterning.[154]
Industrial adoption
[edit]The evolution of multiple patterning is being considered in parallel with the emergence of EUV lithography. While EUV lithography satisfies 10-20 nm resolution by basic optical considerations, the occurrence of stochastic defects[155] as well as other infrastructure gaps and throughput considerations prevent its adoption currently. Consequently, 7nm tapeouts have largely proceeded without EUV.[156] In other words, the multiple patterning is not prohibitive, but more like a nuisance and growing expense.
7nm and 5nm FinFETs
[edit]Self-aligned quadruple patterning (SAQP) is already the established process to be used for patterning fins for 7 nm and 5 nm FinFETs.[157] With SAQP, each patterning step gives a critical dimension uniformity (CDU) value in the sub-nanometer range (3 sigma). Among the logic/foundry manufacturers, only Intel is applying SAQP to the metal layers, as of 2017.[158]
Aggressive multipatterning with DUV only may be applied to 5nm.[159][160]
In 2023, SiCarrier patented a method of achieving 5nm design rules without EUV, effectively achieving the same result as with SAQP.[161]
3nm node
[edit]Aggressive multipatterning with DUV may be applied to even 3nm.[162] Due to the increased expense of EUV multipatterning, DUV multipatterning does not have a cost disadvantage anymore. Aggressive mask reduction can essentially eliminate the mask number difference between DUV and EUV for BEOL patterning.[163][160][161]
2nm node
[edit]For 2nm and beyond, when contacted gate pitch reaches 40 nm and track pitch reaches 20 nm, even EUV will be expected to require substantial multipatterning, with minimal differences in mask count from DUV.[164]
DRAM
[edit]Like NAND Flash, DRAM has also made regular use of multiple patterning. Even though the active areas form a two-dimensional array, one cut mask is sufficient for 20 nm.[165] Furthermore, the cut mask may be simultaneously used for patterning the periphery, and thus would not count as an extra mask.[166] When the active area long pitch is ~3.5 x the short pitch, the breaks in the active area form a hexagonal array, which is amenable to the triangular lattice spacer patterning mentioned above. Samsung has already started manufacturing the 18 nm DRAM.[167] Stitched double patterning is used for the periphery metal routing of DRAM,[51] but for sub-40 nm pitch, a double spacer approach may be needed.[168]
Crossed self-aligned quadruple patterning is used for patterning the capacitor arrays in state-of-the-art DRAM, as of 2025.[169][170]
NAND flash
[edit]Planar NAND flash had several layers which use SADP below 80 nm pitch and SAQP below 40 nm pitch.
3D NAND flash used SADP for some layers. While it does not scale so aggressively laterally, the use of string stacking in 3D NAND would imply the use of multiple patterning (litho-etch style) to pattern the vertical channels.
Typically, for NAND, SADP patterns a set of lines from a core mask, followed by using a trim mask to remove the loop ends, and connecting pads with a third mask.[171]
EUV Multipatterning
[edit]

EUV multiple patterning is not ruled out, especially for 5nm node. This is due to a number of reasons. First, there is the tightening tip-to-tip (T2T) spec, representing the minimum distance between metal line ends.[172] In addition, the distance between cuts must not be too small as to expose portions of lines in between.
When minimum pitch is reduced to 32 nm or less, stochastic defects are prevalent enough [173] to reconsider double patterning at larger design widths.
At pitches of ~30 nm or less, the illumination is also restricted to extremely low pupil fills below 20%,[174][175] which causes a significant portion of the EUV source power to be unused. This lowers the throughput considerably.
Hence, multiple patterning for EUV at wider design rules is presently a practical consideration for both yield and throughput reasons.
In 2025, it was revealed that random 36 nm via patterns required EUV double patterning to avoid excessive doses,[176][177] yet DUV double patterning would have been sufficient.[178]
References
[edit]- ^ Intel 45nm HKMG
- ^ TSMC 28nm cutpoly
- ^ Chao, Weilun; Kim, Jihoon; Anderson, Erik H.; Fischer, Peter; Rekawa, Senajith; Attwood, David T. (2009-01-09). Double patterning HSQ processes of zone plates for 10 nm diffraction limited performance. The 53rd International Symposium on Electron, Ion, and Photon Beams and Nanolithography, Marco Island, FL, May 26–29, 2009.
- ^ Duan, Huigao; Winston, Donald; Yang, Joel K. W.; Cord, Bryan M.; Manfrinato, Vitor R.; Berggren, Karl K. (November 2010). "Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist" (PDF). Journal of Vacuum Science & Technology B, Nanotechnology and Microelectronics: Materials, Processing, Measurement, and Phenomena. 28 (6): C6C58–C6C62. Bibcode:2010JVSTB..28C..58D. doi:10.1116/1.3501353. hdl:1721.1/73447. Archived from the original (PDF) on 2012-01-19.
- ^ D. C. Flanders; N. N. Efremow (1983). "Generation of <50 nm period gratings using edge defined techniques". Journal of Vacuum Science & Technology B. 1 (4): 1105–1108. Bibcode:1983JVSTB...1.1105F. doi:10.1116/1.582643.
- ^ Chris Bencher; Yongmei Chen; Huixiong Dai; Warren Montgomery; Lior Huli (2008). "22nm half-pitch patterning by CVD spacer self alignment double patterning (SADP)". Optical Microlithography XXI. 6924. Optical Microlithography XXI; 69244E: 69244E. Bibcode:2008SPIE.6924E..4EB. doi:10.1117/12.772953. S2CID 121968664.
- ^ A. Vanleenhove; D. Van Steenwinckel (2007). Flagello, Donis G (ed.). "A litho-only approach to double patterning". Society of Photo-Optical Instrumentation Engineers (Spie) Conference Series. Optical Microlithography XX. 6520. Optical Microlithography XX; 65202F: 65202F. Bibcode:2007SPIE.6520E..2FV. doi:10.1117/12.713914. S2CID 119829809.
- ^ "IEEE Andrew S. Grove Award Recipients". IEEE Andrew S. Grove Award. Institute of Electrical and Electronics Engineers. Archived from the original on September 9, 2018. Retrieved 4 July 2019.
- ^ "Micron Named Among Top 100 Global Innovators for Sixth Straight Year". Micron Technology. 2018-02-15. Retrieved 5 July 2019.
- ^ De Simone, Danilo; Vandenberghe, Geert (2019). "Printability study of EUV double patterning for CMOS metal layers". In Goldberg, Kenneth A. (ed.). Extreme Ultraviolet (EUV) Lithography X. p. 21. doi:10.1117/12.2515603. ISBN 978-1-5106-2561-7.
- ^ Milan Vala; Jiri Homola (2014). "Flexible method based on four-beam interference lithography for fabrication of large areas of perfectly periodic plasmonic arrays". Optics Express. 22 (15): 18778–18789. Bibcode:2014OExpr..2218778V. doi:10.1364/OE.22.018778. PMID 25089495.
- ^ a b c van Setten, Eelco; Wittebrood, Friso; et al. (September 4, 2015). "Patterning options for N7 logic: Prospects and challenges for EUV". In Behringer, Uwe F.W; Finders, Jo (eds.). 31st European Mask and Lithography Conference. Vol. 9661. pp. 96610G. Bibcode:2015SPIE.9661E..0GV. doi:10.1117/12.2196426. S2CID 106609033.
- ^ a b Kim, Ryoung-Han; Wood, Obert; Crouse, Michael; Chen, Yulu; Plachecki, Vince; Hsu, Stephen; Gronlund, Keith (2016). "Application of EUV resolution enhancement techniques (RET) to optimize and extend single exposure bi-directional patterning for 7nm and beyond logic designs". In Panning, Eric M.; Goldberg, Kenneth A. (eds.). Extreme Ultraviolet (EUV) Lithography VII. Vol. 9776. pp. 97761R. doi:10.1117/12.2219177.
- ^ R. L. Jones and J. D. Byers, Proc. SPIE 5040, 1035 (2003).
- ^ S. Kobayashi et al., Proc. SPIE 6521, 65210B (2007).
- ^ a b c d R. Kotb et al., Proc. SPIE 10583, 1058321 (2018).
- ^ a b c Y. Borodovsky (2012). EUV Lithography at Insertion and Beyond (PDF). International Workshop on EUV Lithography.
- ^ a b L. T.-N. Wang et al., Proc. SPIE 9781, 97810B (2016).
- ^ C. A. Mack, Proc. SPIE 4226, 83 (2000).
- ^ McLellan, Paul (2017). "TSMC @ N7 with Cadence". Cadence Community Blogs.
- ^ C. T. Bodendorf, Proc. SPIE 5992, 599224 (2005).
- ^ M. Burkhardt et al., Proc. SPIE 6520, 65200K (2007).
- ^ E. Hendrickx et al., Proc. SPIE 6924, 69240L (2008).
- ^ W. N. Partlo et al., Prof. SPIE 1927, 137 (1993).
- ^ T. Winkler et al., Proc. SPIE 5754, 1169 (2005).
- ^ Y. Chen et al., J. Vac. Sci. & Tech. B 35, 06G601 (2017).
- ^ K. Tsujita et al., Proc. SPIE 6520, 652036 (2007).
- ^ T. Winkler et al., Proc. SPIE 5754, 1169 (2005).
- ^ a b K. Tian et al., Proc. SPIE 7274, 72740C (2009).
- ^ DRAM Periphery Metal Patterning Pitch Incompatibilities
- ^ A Forbidden Pitch Combination at Advanced Lithography Nodes
- ^ F. M. Schellenberg et al., DAC 2001,Adoption of OPC and the Impact on Design and Layout.
- ^ V. Wiaux et al., Proc. SPIE 5040, 270 (2003).
- ^ B. Bilski et al., Proc. SPIE 10466, 1046605 (2017).
- ^ Samsung 80nm DRAM
- ^ When Lithography Requires Multiple Patterning: Avoiding Analog Distortions in the Resist Layer
- ^ a b Feature-selective etching in SAQP for sub-20nm patterning
- ^ a b N. Singh and M. Mukherjee-Roy, Proc. SPIE vol. 4691, 1054 (2002).
- ^ J. Garofalo et al., J. Vac. Sci. & Tech. B 11, 2651 (1993).
- ^ T. Matsuda et al., Proc. SPIE 7973, 797316 (2011).
- ^ Intel Technology Journal 45nm issue
- ^ How Line Cuts Became Necessarily Separate Steps in Lithography
- ^ M. Eurlings et al., Proc. SPIE 4404, 266 (2001).
- ^ Vanishing of Half the Fourier Coefficients in Staggered Arrays
- ^ Optimized Illumination for Dense Metal Cut Patterns
- ^ EUV Stochastic Variability in Line Cuts
- ^ DUV or EUV multipatterning for advanced node bidirectional metal layouts
- ^ S-Min Kim et al., Proc. SPIE 6520, 65200H (2007).
- ^ Y. Kohira et al., Proc. SPIE 9053, 90530T (2014).
- ^ Application-Specific Lithography: Sense Amplifier and Sub-Wordline Driver Metal Patterning in DRAM
- ^ a b Stitched Multi-Patterning for Minimum Pitch Metal in DRAM Periphery
- ^ "Scaling-driven nanoelectronics - Resists". Archived from the original on 2010-03-23.
- ^ LaPedus, Mark (March 13, 2008). "JSR demos 'freezing material' for 22-nm production". Archived from the original on 2014-07-15.
- ^ X. Hua et al., J. Vac. Sci. Tech. B, vol. 24, pp. 1850-1858 (2006).
- ^ Y-K Choi et al., J. Phys. Chem. B, vol. 107, pp. 3340-3343 (2003).
- ^ Chao, Robin; Kohli, Kriti K.; Zhang, Yunlin; Madan, Anita; Muthinti, Gangadhara Raja; Hong, Augustin J.; Conklin, David; Holt, Judson; Bailey, Todd C. (2014-01-01). "Multitechnique metrology methods for evaluating pitch walking in 14 nm and beyond FinFETs". Journal of Micro/Nanolithography, MEMS, and MOEMS. 13 (4) 041411. Bibcode:2014JMM&M..13d1411C. doi:10.1117/1.JMM.13.4.041411. ISSN 1932-5150. S2CID 122374784.
- ^ I. Bouchoms et al., Proc. SPIE 7274, 72741K (2009).
- ^ US Patent 6165880, assigned to TSMC.
- ^ Y. Loquet et al., Microelec. Eng. 107, 138 (2013).
- ^ US Patent 8813012, assigned to Synopsys.
- ^ a b R. Brain et al., IITC 2009.
- ^ P. Packan et al., IEDM 2009.
- ^ Ref.: US Patent 8312394, assigned to Synopsys.
- ^ K. Oyama et al., Proc. SPIE 9051, 90510V (2014).
- ^ B. Mebarki et al., U. S. Patent 8,084,310, assigned to Applied Materials.
- ^ a b M. C. Smayling et al., Proc. SPIE 8683, 868305 (2013).
- ^ J. M. Park et al., IEDM 2015, 676 (2015).
- ^ Feature assignments for the spacers in SAQP
- ^ Application-Specific Lithography - 28 nm Pitch Two-Dimensional Routing
- ^ Variable Cell Height Track Pitch Scaling Beyond Lithography
- ^ Synopsis Presentation at Semicon West 2013 Archived 2015-09-24 at the Wayback Machine
- ^ Z. Xiao et al., Proc. SPIE 8880, 888017-3 (2013).
- ^ J. Bekaert et al., Proc. SPIE 9658, 965804 (2015).
- ^ S. H. Park et al., Soft Matter, 6, 120-125 (2010).
- ^ C. G. Hardy and C. Tang, J. Polymer Sci. Pt. B: Polymer Phys., vol. 51, pp. 2-15 (2013).
- ^ L-W. Chang et al.IEDM 2010 Technical Digest, 752-755 (2010).
- ^ NIST 2011 report on LER in PS-b-PMMA DSA
- ^ A. N. Semenov, Macromolecules 26, 6617 (1993).
- ^ A. Gharbi et al., Proc. SPIE 9777, 97770T (2016).
- ^ Sub-10 nm Half-Pitch Density Multiplication by Directed Self-Assembly
- ^ China's Multipatterning Breakthrough? Quadruple Hole Patterning by Directed Self-Assembly on a Staggered Via Grid
- ^ Z. Wu et al., Proc. SPIE 13423, 134231O (2024).
- ^ D. Civay et al., J. Micro/Nanolith. MEMS MOEMS 14, 023501 (2015).
- ^ K. Seki et al., Proc. SPIE 9658, 96580G (2015).
- ^ US Patent 7842601, assigned to Samsung.
- ^ Y. Chen et al., Proc. SPIE 7973, 79731P (2011).
- ^ M. Mirsaeedi et al., IEEE Trans. VLSI Syst. 22, 1170 (2014).
- ^ US Patent 7846849, assigned to Applied Materials.
- ^ S. W. Kim et al., JVST B 34, 040608 (2016).
- ^ a b F. T. Chen et al., Proc. SPIE 8326, 83262L (2012).
- ^ S. Sakhare et al., Proc. SPIE 9427, 94270O (2015).
- ^ N. Mohanty et al., Proc. SPIE 10147, 1014704 (2017).
- ^ Etch Pitch Doubling Requirement for Cut-Friendly Track Metal Layouts: Escaping Lithography Wavelength Dependence
- ^ a b T-B. Chiou et al., Proc. SPIE 9781, 978107 (2016).
- ^ T. H-Bao et al., Proc. SPIE 9781, 978102 (2016).
- ^ a b Y. Chen et al., J. Vac. Sci. Tech. B35, 06G601 (2017).
- ^ M. Crouse et al., Proc. SPIE 10148, 101480H (2017).
- ^ W. Gillijns et al., Proc. SPIE 10143, 1014314 (2017).
- ^ T. Last et al., Proc. SPIE 10143, 1014311 (2017).
- ^ S. Hsu et al., Proc. SPIE 9422, 94221I (2015).
- ^ Merritt, Rick (October 7, 2015). "5nm Test Lights Litho Path Hybrid 193i, EUV seen as best approach". EETimes.
- ^ a b c ASML High-NA EUV
- ^ NVIDIA Pascal Tesla P100 Unveiled - 15.3 Billion Transistors on a 610mm2 16nm Die
- ^ Microlithography: Science and Technology, 2nd ed., B. W. Smith and K. Suzuki (eds.), CRC Press, 2007, p. 94.
- ^ Handbook of Semiconductor Manufacturing Technology, Y. Nishi and R. Doering (eds.), CRC Press, 2000, p. 475.
- ^ Application-Specific Lithography: Via Separation for 5nm and Beyond
- ^ W. Gao et al., Proc.SPIE 11323, 113231L (2020).
- ^ Hynix M1X NAND
- ^ U.S. Patent 9318369, assigned to Samsung.
- ^ Intel discusses 10nm
- ^ Intel unveils 10nm
- ^ Intel goes to 7nm without EUV
- ^ "The Bumpy Road to 10nm FinFETs". 21 May 2015.
- ^ Triple patterning is becoming common at 10nm
- ^ Samsung announces 10nm FinFET process for SoC
- ^ "Semimd - Health & Fitness Magazine 2020". 10 November 2023.
- ^ S. Y. Wu et al., IEDM 2016, paper 2.7.
- ^ a b IEDM 2016 Setting Stage for 7/5 nm
- ^ F. T. Chen et al., Proc. SPIE 8683, 868311 (2013).
- ^ Raley, Angélique; Thibaut, Sophie; Mohanty, Nihar; Subhadeep, Kal; Nakamura, Satoru; Ko, Akiteru; O'Meara, David; Tapily, Kandabara; Consiglio, Steve; Biolsi, Peter (2016). "Self-aligned quadruple patterning integration using spacer on spacer pitch splitting at the resist level for sub-32nm pitch applications". In Lin, Qinghuang; Engelmann, Sebastian U. (eds.). Advanced Etch Technology for Nanopatterning V. Vol. 9782. pp. 97820F. doi:10.1117/12.2219321.
- ^ F. T. Chen et al., Proc. SPIE vol. 8326, 82362L (2012).
- ^ a b c "14 nm lithography process - WikiChip".
- ^ a b [1] A. Yeoh et al., IITC 2018.
- ^ U.S. Patent Application 20150179513
- ^ Swati Chavan; Jayesh Prajapati; Akash Verma. "A Heuristic Approach to Fix Design Rule Check (DRC) Violations in ASIC Designs @7nm FinFET Technology". Design & Reuse.
- ^ TSMC on 2017
- ^ a b J. Kim et al., Proc. SPIE 10962, 1096204 (2019).
- ^ Calibre support for 8LPP and 7LPP
- ^ a b [2] H. Rhee et al., 2018 Symp. VLSI Tech., 217.
- ^ Mentor extends 7nm FinFET Plus support
- ^ TSMC 2019 Q2 earnings call
- ^ R. R. Haque et al., Proc. SPIE 9776, 97760F (2016).
- ^ Samsung receives 24 immersion tools from ASML in 2010
- ^ Extending immersion lithography to 1xnm nodes
- ^ EUV Errors Under Attack
- ^ a b M. C. Smayling et al., Proc. SPIE 8683, 868305 (2013).
- ^ a b Multipatterning Reduction with Gridded Cuts and Vias
- ^ a b Simplifying Multipattering with Gridded Cuts and Vias
- ^ a b Exploring Grid-Assisted Multipatterning Scenarios for 10A-14A Nodes
- ^ a b US Patent 9240329
- ^ a b US Patent application 20170221902
- ^ US Patent 8697538
- ^ P. Bisschop and E. Hendrickx, Proc. SPIE 10583, 105831K (2018).
- ^ P. Woltgens et al., Proc. SPIE 12051, 120510I (2022).
- ^ Staggered Vias Better Routing Than In-Line Vias
- ^ Q. Lin, Proc. SPIE 11327, 113270X (2020).
- ^ SALELE double patterning for 7nm and 5nm nodes
- ^ F. Lazzarino et al., Proc. SPIE 10149, 1014908 (2017)
- ^ Z. Xiao et al., Proc. SPIE 8880, 888017 (2013).
- ^ Self-Aligned Block Redistribution and Expansion for Improving Multipatterning Productivity
- ^ J-H. Franke et al., Proc. SPIE 10145, 1014529 (2017).
- ^ 2nm Routing and Patterning Simplification with Diagonal Via Grid
- ^ Routing and Patterning Simplification with a Diagonal Via Grid
- ^ A Subtle Design Rule Implementation Can Significantly Reduce Multipatterning
- ^ P. De Bisschop and E. Hendrickx, Proc. SPIE 10583, 105831K (2018).
- ^ TSMC tapeouts in 2018
- ^ SAQP for FinFETs
- ^ Intel 14 nm Leadership
- ^ Q. Wu et al., CSTIC 2023.
- ^ a b 4 Functions of DUV Masks for 5nm/3nm BEOL Patterning
- ^ a b SiCarrier's SAQP-Class Patterning Technique: a Potential Domestic Solution for China's 5nm and Beyond
- ^ Extension of DUV Multipatterning Toward 3nm
- ^ BEOL Mask Reduction Using Spacer-Defined Vias and Cuts
- ^ Via Multipatterning Regardless of Wavelength as High-NA EUV Lithography Becomes Too Stochastic
- ^ Y-S. Kang et al., J. Micro/Nanolith. MEMS MOEMS vol. 15(2), 021403 (2016).
- ^ U.S. Patent 7253118.
- ^ Samsung 18 nm DRAM
- ^ Self-Aligned Spacer Patterning for Minimum Pitch Metal in DRAM
- ^ Crossed Self-Aligned Multipatterning For Sub-40 nm Pitch Grids: A Process On Record For DRAM
- ^ Md. S. Rahman et al., Proc. SPIE 13427, 134270G (2025).
- ^ H. Dai et al., Proc. SPIE 7275, 72751E (2009).
- ^ J. Van Schoot et al., Proc. SPIE 11147, 1114710 (2019).
- ^ S. Kang et al., Proc. SPIE 11611, 1161129 (2021).
- ^ D. Rio et al, Proc. SPIE 11609, 116090T (2021).
- ^ J-H. Franke et al., Proc. SPIE 11517, 1151716 (2020).
- ^ C. Zahlten, Proc. SPIE 13424, 134240Z (2025).
- ^ Stochastic EUV Exposure of 36 nm Via
- ^ High-NA Hard Sell: EUV Multipatterning Practices Revealed, Depth of Focus Not Mentioned
Multiple patterning
View on GrokipediaIntroduction to Lithography Challenges
Resolution Limits in Optical Lithography
The resolution in optical lithography is fundamentally governed by the Rayleigh criterion, which defines the minimum resolvable feature size, or critical dimension (CD), as $ R = k_1 \frac{\lambda}{NA} $, where is the wavelength of the illuminating light, is the numerical aperture of the projection optics, and is a process-dependent factor that accounts for the specifics of the imaging system, mask, and resist.[5] This equation highlights the three primary levers for improving resolution: reducing , increasing , and minimizing . In practice, values for advanced semiconductor nodes typically range from 0.25 to 0.3, reflecting optimizations in illumination schemes, mask design, and computational lithography techniques.[6] Diffraction imposes a physical limit on optical lithography, preventing the faithful reproduction of features smaller than approximately in a single exposure without significant distortion, as the wave nature of light causes interference patterns that blur fine details.[7] This diffraction barrier arises from the finite aperture of the optics, which filters out higher spatial frequencies necessary for sharp imaging of sub-wavelength structures, leading to aerial image contrast loss and pattern fidelity degradation.[8] Historically, 193 nm argon fluoride (ArF) immersion lithography emerged as the industry standard for scaling beyond the 45 nm node, enabling production at 22 nm and 14 nm technology nodes through high- optics (up to 1.35) and resolution enhancement techniques, but it encounters severe challenges for sub-10 nm features due to the fixed and diminishing returns on increases.[9] Further reductions in below 0.25 are theoretically constrained by the physics of coherent imaging limits, and in practice, they introduce excessive defects such as stochastic noise and pattern collapse from poor image contrast.[5] At low values, optical proximity effects (OPE) become pronounced, exacerbating issues like line-edge roughness (LER), where random variations in the edge profile of printed features arise from reduced aerial image contrast and photon shot noise in the resist.[10] LER, typically quantified as the standard deviation of edge position (often 2-5 nm at advanced nodes), degrades device performance by increasing variability in transistor dimensions and leakage currents, making single-exposure printing untenable for sub-10 nm scales.[11] These limits have driven the adoption of multiple patterning strategies to effectively halve the effective without violating single-exposure physics.Need for Multiple Patterning
Multiple patterning refers to a set of lithographic techniques that employ multiple sequential exposures and etching steps to form a single final pattern on a semiconductor wafer, thereby surpassing the resolution limits of single-exposure optical lithography by effectively lowering the process factor k1 in the Rayleigh criterion for resolution.[12][13] Adopting multiple patterning requires careful decomposition of the integrated circuit layout into separate masks, each handling a portion of the overall pattern, along with stringent control of alignment tolerances to ensure precise overlay between layers. For advanced nodes such as 5nm, overlay errors must be maintained below 2nm to avoid defects that could compromise device performance.[14][15] This approach enables the fabrication of features with half-pitches as small as 10-20nm using existing 193nm immersion lithography tools, bridging the gap until the widespread availability of extreme ultraviolet (EUV) lithography and thereby sustaining the scaling trajectory of Moore's Law in the pre-EUV era.[12][16] Intel first commercially adopted multiple patterning at the 45 nm node in 2008, with significant implementation at the 22 nm node around 2011, particularly for metal layers requiring tight pitches and complex layouts, and broader industry adoption following for 20 nm processes.[17][18][13] However, these techniques introduce significant tradeoffs, including heightened process complexity from additional lithography and etch cycles, elevated manufacturing costs due to more masks and steps, and increased risks of defects from overlay variations and pattern interactions compared to single-patterning methods.[12][19]Situations Requiring Multiple Patterning
Sub-Resolution Pitch Challenges
In optical lithography, sub-resolution pitch refers to the scenario where the pitch of features, defined as the distance between repeating elements such as lines in a grating, falls below twice the resolution limit of the system, causing interference fringes from adjacent features to overlap and degrade pattern fidelity.[20] This limitation arises from the fundamental Rayleigh criterion, which sets the minimum resolvable half-pitch based on wavelength, numerical aperture, and process factor.[20] As a result, single-exposure patterning fails to produce distinct features, necessitating multiple patterning techniques to achieve the required density. A prominent example occurs in one-dimensional grating patterns, such as those in metal interconnect layers of advanced logic devices, where attempting a single exposure at pitches below 40 nm leads to line merging and loss of critical dimensions.[20] In these cases, uniform dense lines intended for sub-20 nm half-pitches cannot be resolved without splitting the pattern across multiple masks, as the overlapping diffraction orders prevent clean aerial image formation.[12] The pitch doubling concept addresses this by decomposing a coarse, resolvable pattern into two or more offset finer patterns, each exposed and etched separately, effectively halving the pitch per step.[20] This approach, foundational to litho-etch-litho-etch (LELE) double patterning, enables denser arrays while staying within the resolution capabilities of immersion lithography tools.[21] Mathematically, multiple patterning with n exposures can reduce the effective pitch by a factor of n (for binary splitting in LELE), allowing sub-10 nm half-pitches from initial patterns at 64 nm or larger; however, overlay errors accumulate across steps, propagating as $ \sqrt{n} $ times the single-exposure error, which demands stringent control such as an overlay budget where the standard deviation $ \sigma_{\text{overlay}} < \frac{\text{half-pitch}}{6} $ to maintain edge placement accuracy below 10% of the feature size.[20][22] Misalignment in these processes particularly exacerbates bridge defects in dense linear arrays, where adjacent lines unintentionally connect due to overlay shifts exceeding 5-10% of the pitch, reducing yield in critical layers like gates or contacts.[20] Such defects are amplified in repetitive 1D structures, requiring advanced metrology and correction schemes to mitigate stochastic and systematic errors.[20]Two-Dimensional Patterning Issues
In optical lithography, two-dimensional (2D) patterns encounter significant distortions due to diffraction effects during single-exposure printing, particularly as feature sizes approach the diffraction limit. Sharp corners in irregular 2D shapes, such as those found in logic gates or interconnects, tend to round off because high spatial frequency components required for precise edges are lost in the diffraction process, leading to blurred or softened contours in the resist image.[23] This rounding degrades pattern fidelity and can compromise device performance by altering critical dimensions and electrical properties.[24] A key challenge in 2D patterning is the tradeoff between line tip extension and overall linewidth control. To elongate line tips and mitigate end-shortening caused by diffraction, optical proximity corrections (OPC) often require widening the line body elsewhere on the mask, which violates design rules for uniform linewidths and increases manufacturing variability.[25] At low k1 values, this issue intensifies, requiring significant OPC that can widen linewidths elsewhere. In contact and via arrays, these diffraction-induced distortions manifest as circular design holes printing as elliptical shapes, with elongation often favoring one axis due to asymmetric aerial image formation.[23] This ellipticity reduces contact area and can lead to yield losses in interconnect layers. Illumination source optimization further complicates 2D patterning with mixed orientations. Dipole sources enhance resolution for features aligned perpendicular to the pole orientation (e.g., horizontal lines with a vertical dipole), but they underperform for orthogonal features, necessitating separate exposures.[26] Annular sources provide more isotropic illumination suitable for random 2D layouts, yet they offer inferior contrast and resolution compared to dipole for unidirectional patterns, limiting their effectiveness in hybrid orientations without multiple patterning.[26]Complex Layouts and Multi-Pitch Patterns
Complex layouts in multiple patterning lithography often involve regions with varying feature densities or pitches, which cannot be adequately addressed by uniform single- or double-patterning approaches due to the inherent limitations of optical resolution and process uniformity. In such scenarios, even minor variations in pitch across a layout can lead to significant challenges in mask decomposition, as these irregularities disrupt the regular alternation required for color assignment in double patterning. This results in color conflicts, where features that should be assigned to separate masks violate spacing rules, necessitating additional masks or layout modifications to resolve the incompatibilities.[27] Slight deviations from the ideal two-beam interference conditions in grating structures further complicate patterning, as small pitch variations amplify optical proximity effects (OPE), leading to enhanced linewidth variations and edge distortions that degrade pattern fidelity. For instance, in dense gratings, non-uniform pitches cause asymmetric diffraction and increased scattering, exacerbating CD through-pitch variations beyond what uniform pitch splitting can correct. Additionally, layouts containing both horizontal and vertical features demand tailored illumination strategies; horizontal lines benefit from vertical dipole illumination to optimize contrast, while vertical lines require horizontal dipole setups, often mandating decomposition into separate masks to align with these orientation-specific source conditions. A representative example of these challenges arises in contact hole arrays with varying sizes or irregular arrangements, where standard double patterning fails to achieve sufficient resolution and uniformity, requiring quadruple patterning to define precise positions and dimensions. In such cases, self-aligned quadruple patterning processes are employed to multiply hole patterns from a coarser pre-pattern, enabling sub-20 nm half-pitches while accommodating size variations that would otherwise cause overlay errors or incomplete etching. The decomposition of these complex layouts is fundamentally modeled as a graph coloring problem, where features are vertices and spacing constraints form edges; odd-length cycles in the conflict graph necessitate more than two colors (masks), rendering the problem NP-hard and requiring heuristic algorithms for practical resolution.[28]Decomposition-Based Techniques
Pitch Splitting
Pitch splitting is a decomposition-based multiple patterning technique used in optical lithography to achieve feature densities beyond the single-exposure resolution limit, particularly for one-dimensional periodic structures like dense line arrays. This method addresses sub-resolution pitch challenges by dividing a dense layout into multiple, sparser masks that can be resolved individually with conventional immersion lithography tools.[12] The core process flow, known as litho-etch-litho-etch (LELE), begins with decomposing the target layout into alternating subsets, such as odd and even lines, to create two independent masks with doubled pitch. The first mask is exposed and etched into the substrate, forming initial features; then, a second photoresist layer is applied, the second mask is exposed and aligned to the first pattern, and the adjacent features are etched. Finally, end-to-end trimming steps are performed using additional lithography and etch processes to connect the split segments and define precise line lengths, ensuring a continuous final pattern without gaps or overlaps.[12] Variants of pitch splitting extend this approach for finer resolutions. Double patterning halves the effective pitch by using two LELE steps, suitable for pitches around 40 nm at the 7 nm node. Quadruple patterning further splits the layout into four masks via two sequential double patterning cycles (LELELELE), achieving quarter-pitch densities for even tighter features, though at increased complexity.[12] A primary challenge in pitch splitting is alignment, where precise overlay control between successive exposures is critical to avoid bridging or necking defects. For the 7 nm node, overlay must be maintained to within 2 nm to ensure reliable pattern fidelity and device performance.[19] Pitch splitting finds primary application in patterning metal lines within the backend-of-line (BEOL) interconnects, where regular, dense wiring requires high fidelity at sub-20 nm pitches. Historically, Intel first implemented double pitch splitting at the 22 nm node in 2011 to enable 90 nm pitch metal layers supporting complex 2D routing.[29] In terms of implementation, pitch splitting roughly doubles the number of masks and process steps compared to single patterning, significantly elevating manufacturing costs due to additional lithography and etch operations.[12]Line Cutting
Line cutting is a decomposition-based multiple patterning technique that addresses the challenges of fabricating complex two-dimensional (2D) patterns at advanced nodes by first creating continuous lines and then selectively segmenting them. The process begins with patterning long, parallel lines using a primary lithography step, often with a relaxed pitch that exceeds the resolution limit of the tool, allowing for higher fidelity in line formation. A secondary lithography exposure then defines narrow cuts at precise intersections, etching away portions of the lines to create the required discontinuities and shapes. This two-step approach, sometimes enhanced with complementary polarity exposures to optimize cut placement, enables the realization of intricate features without the need for full 2D decomposition in the initial patterning stage.[30] One key advantage of line cutting is its ability to reduce the complexity associated with 2D pattern decomposition, as the primary lines can be formed with fewer overlay constraints, and precision is focused solely on the cut locations. Overlay errors are thus localized to these cuts, simplifying alignment and improving overall process yield compared to traditional multi-exposure methods for dense 2D layouts. The cuts themselves are typically 10-20 nm wide, achieved using deep ultraviolet (DUV) immersion lithography or emerging extreme ultraviolet (EUV) tools to ensure sub-20 nm precision at pitches down to 40 nm.[30] This technique is particularly beneficial for simplifying complex layouts, such as those with irregular pitches or dense interconnects, by converting them into unidirectional lines prior to segmentation. Practical applications of line cutting include gate cuts in FinFET transistors, where continuous gate lines are segmented to isolate individual devices, and via cuts in back-end-of-line (BEOL) interconnects to define precise contact points without bridging adjacent metals. However, defect risks arise from process variations, such as line edge roughness (LER), which can result in incomplete cuts and lead to electrical shorts between features, potentially causing yield loss in high-density regions.[12] Line cutting gained significant adoption in industry, notably as a core element in TSMC's 7 nm process node for patterning the M0 and M1 metal layers, where self-aligned double patterning (SADP) forms the initial lines and a dedicated cut mask handles segmentation to achieve the required densities.[12]Self-Aligned Techniques
Sidewall Image Transfer and Basic SADP
Sidewall image transfer (SIT) and basic self-aligned double patterning (SADP) represent a pioneering self-aligned approach to pitch multiplication in optical lithography, enabling sub-resolution features without requiring multiple lithographic exposures. The process initiates with the lithographic definition and etching of sacrificial mandrels, or core patterns, on a substrate, typically spaced at the resolution limit of the lithography tool. A thin conformal film, such as silicon dioxide or silicon nitride, is then deposited via chemical vapor deposition, uniformly coating the mandrels and exposing the substrate between them.[31] An anisotropic reactive ion etch is subsequently applied to remove the deposited film from horizontal surfaces, resulting in sidewall spacers that remain adhered to the vertical edges of the mandrels; this etch-back step effectively doubles the pattern density by creating features at half the original pitch. The mandrels are then selectively removed, and the spacer-defined pattern is transferred to the substrate through a final directional etch, where the spacers serve as a hard mask to define the ultimate features. This transfer leverages the precise geometry of the spacers to replicate high-fidelity edges, as first demonstrated in early edge-defined grating fabrication.[31] The self-aligned mechanism of SADP inherently minimizes overlay errors by eliminating the need for secondary lithographic alignment, achieving sub-nanometer precision in advanced nodes—often less than 1 nm—compared to traditional double patterning methods that suffer from exposure-to-exposure misalignment. This advantage stems from the conformal deposition and etch processes, which position spacers relative to the core pattern without additional masking steps. Unlike pitch splitting, which relies on non-self-aligned dual exposures, basic SADP uses a single lithographic print for the mandrels, reducing sensitivity to tool overlay variations.[32] In practice, basic SADP has been widely adopted for one-dimensional structures in logic devices, such as fin patterning in 14 nm FinFET transistors, where it enables uniform, high-aspect-ratio features at pitches around 40-50 nm. For instance, Intel's 14 nm process employed SADP for critical gate and fin layers to achieve reliable density scaling. However, the technique is limited to highly regular, unidirectional arrays, as the fixed positioning of spacers relative to mandrels complicates accommodation of two-dimensional or multi-pitch layouts, often requiring additional trimming or cuts that increase complexity.[32][33] The pitch multiplication is mathematically expressed as an effective pitch $ P_{\text{effective}} = \frac{P_{\text{original}}}{2} $, where $ P_{\text{original}} $ is the mandrel pitch; the final critical dimension is primarily dictated by the thickness of the deposited spacer film, which must be precisely controlled during deposition to ensure uniformity across the wafer.[31]Spacer-Is-Dielectric Double Patterning (SID SADP)
Spacer-Is-Dielectric Double Patterning (SID SADP) represents an advanced variant of self-aligned double patterning (SADP) tailored for enhanced compatibility with two-dimensional layouts and reduced defectivity in semiconductor manufacturing. In this technique, dielectric materials serve as the final spacers that define spaces between patterned features, contrasting with traditional SADP approaches that rely on sacrificial spacers requiring removal. This configuration allows for greater flexibility in patterning complex, non-periodic structures at sub-20 nm pitches, making it suitable for interconnects and memory arrays where precise control over line widths and spaces is critical. By leveraging the dielectric spacers directly, SID SADP minimizes overlay errors inherent in litho-etch-litho-etch (LELE) methods, achieving self-alignment through sidewall deposition and etching processes.[34] The core advantage of SID SADP lies in its use of low-k dielectric spacers, which replace higher-stress sacrificial materials like amorphous carbon or silicon, thereby reducing film stress and improving structural integrity during integration. These low-k materials, often with dielectric constants below 3.0, also enhance gap fill in subsequent metallization steps by providing better conformal coverage and lower capacitance in back-end-of-line (BEOL) layers. Additionally, the dielectric nature of the spacers offers superior etch selectivity during pattern transfer, enabling cleaner delineation of features without residue or bridging defects that plague sacrificial spacer flows. For instance, in contact layers, SID SADP facilitates hole shrinking by depositing thin dielectric liners inside pre-patterned vias, reducing critical dimensions by up to 20% while maintaining sidewall uniformity.[35][36] The process flow for SID SADP begins with mandrel formation, where a core (mandrel) mask patterns initial features—typically wider lines or trenches—onto a hard mask layer using lithography and etch. A conformal low-k dielectric film, such as silicon oxycarbide, is then deposited via chemical vapor deposition to wrap the mandrels uniformly, forming spacers of controlled thickness equal to half the target pitch. Anisotropic etching follows to remove excess dielectric from horizontal surfaces, leaving sidewall spacers intact. The mandrels are selectively pulled via wet or dry etch, exposing the underlying substrate where the spacers now define the dielectric spaces. Finally, pattern transfer etches the target layer (e.g., oxide or metal) using the spacers as a hard mask, followed by spacer removal or retention depending on the integration scheme. This sequence ensures pitch doubling with minimal masks, typically requiring only a mandrel mask and a block mask for trimming non-linear features.[37] To extend SID SADP to two-dimensional patterns, angled deposition techniques are employed during spacer formation, enabling the creation of triangular or honeycomb arrays by shadowing effects that selectively deposit material on sidewalls. This approach is particularly effective for dense, hexagonal layouts, as seen in DRAM capacitor patterning, where it triples density compared to single patterning while avoiding cuts in periodic regions. Samsung used self-aligned double patterning (SADP) for honeycomb-structured capacitor holes in its 20 nm DRAM node, achieving an effective pitch of around 26 nm and improving cell capacitance by 21% relative to prior generations. Overall, these enhancements position SID SADP as a bridge to extreme ultraviolet (EUV) lithography, supporting scaling to 16 nm pitches in metal lines with reduced defect densities below 0.1/cm².[38][39]Self-Aligned Quadruple Patterning (SAQP)
Self-aligned quadruple patterning (SAQP) extends self-aligned double patterning (SADP) by performing two successive spacer deposition and etching cycles, enabling a fourfold pitch reduction from the initial lithographic pattern. The process begins with a mandrel patterned via 193 nm immersion lithography at a relatively coarse pitch, such as 90 nm, followed by conformal deposition of silicon dioxide spacers using atomic layer deposition (ALD). Anisotropic etching with fluorine-based plasma defines the first set of sidewalls, and the mandrel is selectively removed using oxygen plasma. An intermediate trimming step, typically involving dilute hydrofluoric acid cleaning, refines the features to mitigate any asymmetry before the second spacer deposition and etching cycle, which uses similar ALD and plasma etch steps but with chlorine-based mandrel removal. The resulting quadruple pattern is then transferred into underlying layers like silicon nitride pads and bulk silicon via reactive ion etching.[40] This iterative approach achieves a density multiplication factor of 4x, dividing the original pitch by four to pattern ultra-fine features critical for advanced nodes, such as fins at 18–28 nm pitch in 5 nm processes or gates approaching 3 nm dimensions. For instance, in high-density fin arrays, SAQP can produce fin top critical dimensions (CD) of about 7 nm with heights up to 115 nm, far beyond single-exposure limits of deep ultraviolet lithography.[40] Key challenges in SAQP include cumulative spacer asymmetry from non-conformal deposition or etching, which induces pitch walking—non-uniform spacing that degrades overlay—and demands exceptional CD control, often targeting sub-1 nm uniformity (3σ) for critical dimensions and pitch walk. Achieving this requires precise process modeling and metrology to minimize line edge roughness (around 2.2 nm) and line width roughness (1.2 nm), as deviations amplify across the multi-step sequence.[41][40] Intel employed SAQP for active patterns, including fin formation, in its 10 nm logic technology—equivalent to industry 7 nm scaling—with a 34 nm fin pitch and 7 nm fin width, enabling third-generation FinFETs in high-performance and low-power applications without initial EUV reliance.[42] Variants of SAQP incorporate multi-spacer reduction through additional deposition-etch iterations, achieving greater than 4x density multiplication, such as in self-aligned octuple patterning (SAOP) or sextuple patterning (SASP) for sub-10 nm nodes. However, as iterations increase, pitch walking and overlay errors accumulate exponentially, limiting practical use for dense 2D logic patterns at 3nm and below without EUV assistance. Extensions to 5nm-class in constrained environments (e.g., Chinese SMIC/Huawei patents using SAQP for 5nm) highlight higher mask counts (up to 6 per layer) and yield challenges due to amplified variability. Overall, SAQP proved essential for sub-7 nm feature patterning in the pre-full EUV era, supporting dense 1D structures like fins before EUV maturity reduced multi-patterning complexity.[12]Advanced and Hybrid Methods
Directed Self-Assembly (DSA)
Directed self-assembly (DSA) leverages the phase separation of block copolymers (BCPs) to form ordered nanoscale domains, such as cylinders or spheres, which serve as templates for high-resolution patterning in semiconductor manufacturing. This bottom-up approach is guided by top-down lithographic pre-patterns to achieve long-range order and precise placement, enabling features beyond the resolution limits of conventional lithography without requiring multiple exposures. The self-assembly is driven by the Flory-Huggins interaction parameter (χ), which quantifies the incompatibility between polymer blocks, promoting microphase separation into thermodynamically stable morphologies like cylindrical domains suitable for via patterning.[43][44] The DSA process primarily employs two directing strategies: chemoepitaxy and graphoepitaxy. In chemoepitaxy, chemical pre-patterns on the substrate, such as neutral and preferential regions created via techniques like LiNe or ULST flows, induce selective wetting of BCP blocks to align domains perpendicularly or in-plane. Graphoepitaxy, conversely, uses topographic templates like trenches or posts fabricated by 193 nm lithography to confine and orient the BCP film, promoting epitaxial growth along the guiding features. These methods allow integration with existing immersion lithography tools, where the pre-pattern defines coarse layout and the BCP multiplies density through natural domain spacing.[43][44] DSA achieves sub-10 nm feature sizes and pitch multiplication factors exceeding 10, such as 9× for hexagonal hole arrays at 30 nm pitch, enabling dense periodic structures unattainable by direct patterning. In logic devices, it is applied to via and contact arrays, improving local critical dimension uniformity (LCDU) from 1.71 nm to 1.41 nm by rectifying lithographic imperfections. For memory, DSA supports hole patterning in DRAM, reducing defects in capacitor arrays and enhancing pattern fidelity at advanced nodes like 7 nm FinFETs.[44] Key challenges include high defectivity, with current densities around 10 defects/cm²—far above the <1/cm² target for production—arising from dislocations due to phase misalignment or bridging between domains, which require optimized annealing to mitigate. Integration with 193 nm pre-patterns demands precise control of surface energy and thickness to avoid misalignment, while compatibility with extreme ultraviolet (EUV) lithography adds complexity in material selectivity. In 2025, Intel researchers demonstrated hybrid DSA-EUV for 3 nm and beyond nodes, using DSA to rectify line/space patterns at 24 nm pitch, reducing line edge roughness (LER) to 1.70 nm and line width roughness (LWR) to 1.40 nm, paving the way for dose-efficient sub-10 nm scaling. IMEC has also advanced hybrid DSA-EUV pilots in this area.[44]Other Specialized Techniques
Self-aligned triple patterning (SATP) combines elements of litho-etch-litho-etch (LELE) processes with spacer-based self-alignment to achieve odd-multiple patterning densities, offering reduced overlay sensitivity compared to traditional triple patterning for features down to sub-15 nm half-pitch. This hybrid approach typically involves an initial mandrel patterning followed by spacer deposition and selective etching to form three distinct lines from two masks, enabling quasi-two-dimensional design flexibility in advanced nodes.[45] Tilted ion implantation (TII) defines sub-lithographic patterns by directing ions at an oblique angle into a masking layer, creating shadowed regions that enhance etch selectivity without requiring additional lithography steps.[46] The technique exploits ion damage to accelerate etching in exposed areas, allowing features smaller than the original mask—such as lines or vias at half the pre-existing pitch—to be formed cost-effectively, with demonstrated resolution below 20 nm using argon ions on silicon dioxide layers.[47] In display technology, TII facilitates fine patterning of thin-film transistor arrays in active-matrix liquid crystal displays (AMLCDs) and organic light-emitting diode (OLED) panels, where it enables precise doping and sidewall definition to improve pixel density and uniformity.[48] Complementary polarity exposures reduce mask count in line-cutting by using positive and negative tone resists in tandem, where one exposure defines broad areas to protect and the other removes unwanted segments, effectively combining multiple cuts into two aligned patterns. This method is particularly advantageous for dense interconnects, as it minimizes overlay errors associated with numerous individual cut masks, achieving up to 50% fewer exposures while maintaining edge placement accuracy in 193 nm immersion lithography extensions. Self-aligned blocking, also known as self-aligned cutting, employs deposited blockers or local masks formed via selective deposition to terminate lines and prevent over-etching in multi-patterned arrays, ensuring electrical isolation without dedicated trim masks for each endpoint.[49] The process leverages material selectivity—such as carbon-based blockers on metal lines—to create self-registering barriers, reducing mask complexity and edge placement error budgets in sub-40 nm pitches.[50] As of 2025, machine learning-assisted pattern segmentation, exemplified by Siemens' ML-SRPP (Machine Learning Statistics Risk Pattern Predictor), optimizes these specialized techniques by predicting defect risks and decomposing layouts into viable multi-pattern segments, enhancing yield in hybrid flows with up to 20% improved critical dimension control.Implementation Considerations
Costs and Mask Requirements
Multiple patterning techniques substantially elevate mask requirements compared to single patterning, typically demanding 2 to 4 masks per affected layer to achieve sub-resolution features through sequential exposures and etches. This escalation arises because each patterning step—such as in double patterning (LELE: litho-etch-litho-etch) or self-aligned quadruple patterning (SAQP)—requires dedicated masks for distinct subsets of the layout, preventing interference from diffraction limits. For advanced nodes like TSMC's 5 nm process, total mask counts surpass 80 layers, a figure reduced from a potential 115 through EUV integration but still reflecting the multiplicative impact of multiple patterning on non-EUV layers.[19][51] Mask fabrication costs form a critical economic barrier, with individual advanced masks priced at $100,000 to over $1 million due to intricate patterning and materials like those for ArF immersion or EUV. Full mask sets for a single chip design at leading-edge nodes thus exceed $10 million, and multiple patterning amplifies this by 2-4 times per layer, contributing 20-50% to overall wafer processing costs through added fabrication, inspection, and alignment expenses. Published data from TSMC illustrates this: their 7 nm multiple patterning flow incurs mask set costs of approximately $15 million, roughly 3 times the $5 million for 16/14 nm nodes, driven by triple and quadruple patterning in metal and contact layers.[52][53][54] Layout decomposition into multiple masks imposes stringent design rule adjustments, including widened minimum spacings (often 1.5-2x single-patterning pitches) to enable conflict-free assignment of features to masks. Coloring conflicts emerge when odd-cycle graphs in the layout prevent bipartite or tripartite decomposition without violations, potentially requiring feature splitting, dummy fills, or rerouting to resolve, which complicates physical design flows and increases turn-around time.[55][56] Alignment precision across masks is addressed through model-based optical proximity correction (OPC), which simulates multi-exposure interactions to refine mask contours, minimizing overlay errors and process variations in critical layers.[57]Productivity and Tooling
Multiple patterning techniques in semiconductor manufacturing involve multiple lithography and etch cycles per layer to achieve sub-20 nm feature sizes, typically ranging from 1 to 4 cycles depending on the complexity of the pattern. For instance, litho-etch-litho-etch (LELE) double patterning requires two full lithography-etch cycles, while self-aligned quadruple patterning (SAQP) employs a single initial lithography step followed by two cycles of spacer deposition and selective etching to quadruple the pattern density.[12][58] These additional cycles increase tool demands, with SAQP often requiring 2-3 specialized tools per cycle for conformal deposition, anisotropic etching, and trimming to ensure precise pitch multiplication without defects. High-numerical-aperture (high-NA) immersion scanners, such as the ASML TWINSCAN NXT:2050i with 1.35 NA, are essential for these processes, providing the resolution needed for advanced logic and memory nodes while supporting 300 mm wafer production. By 2025, hybrid EUV-DUV lithography tools have emerged to optimize multiple patterning, combining deep ultraviolet (DUV) immersion for less critical layers with extreme ultraviolet (EUV) for high-resolution steps, thereby reducing overall cycle times in hybrid flows.[59][60] Wafer throughput on these immersion scanners reaches approximately 295 wafers per hour (wph), but multiple patterning effectively halves this rate for double patterning and further reduces it for quadruple schemes due to repeated exposures and processing. For example, quadruple patterning at the 7 nm node can demand up to four times the lithography exposures of single patterning, potentially requiring fourfold the scanner capacity—such as 24 tools for multi-pass flows versus 6 for single-exposure equivalents—to sustain fab output. Productivity enhancements include parallel wafer processing in multi-chamber tools to handle simultaneous cycles and inline metrology systems for real-time overlay and critical dimension monitoring, which minimize downtime and enable faster yield ramps.[59][4]Unique Challenges in Multiple Patterning
One of the primary technical difficulties in multiple patterning arises from overlay and critical dimension (CD) errors, which propagate cumulatively across multiple litho-etch steps, exacerbating edge placement errors (EPE) and line edge roughness (LER). In litho-etch-litho-etch (LELE) configurations, for instance, overlay inaccuracies entangle with CD variations and stochastic effects, leading to amplified local and global errors that can dominate the EPE budget in logic devices. Studies indicate that even a 1 nm overlay error can effectively double the LER impact in subsequent patterning steps due to this propagation, particularly in dual-layer processes where random CD fluctuations add to systematic misalignments.[61][62] Defect types unique to multiple patterning include stochastic noise in spacer formation and bridging during cut steps, both of which stem from resist variability and process instabilities. Stochastic noise, driven by shot noise and photon fluctuations in the resist, induces sidewall roughness in self-aligned double patterning (SADP) spacers, potentially causing pitch walking or incomplete spacer definition that propagates to final patterns. Bridging defects, often occurring in cut or trim steps, result from incomplete etching or residual material between features, leading to short circuits; inverse lithography techniques have been employed to mitigate these by optimizing mask pixels to reduce hotspots in 14 nm and 10 nm nodes. These defects are particularly challenging in spacer-based flows, where even minor resist profile variations can amplify failure risks.[63][64][65] Mixed methods, such as combining LELE with SADP for hybrid layers, introduce additional challenges in interconnect patterning at advanced nodes, where variability in metal lines arises from differing alignment requirements and process interactions between the two techniques. Hybrid regimes utilizing 193 nm immersion lithography must account for increased CD non-uniformity and overlay sensitivity when SADP spacers interface with LELE-defined features, complicating decomposition and increasing the risk of systematic defects like pitch doubling errors. These combinations are essential for complex layouts but demand precise co-optimization to control interconnect variability. Addressing these issues requires advanced metrology, including scanning electron microscopy (SEM) and atomic force microscopy (AFM), to verify multi-mask alignments and measure sub-10 nm features across patterning steps. CD-SEM provides high-resolution imaging for overlay and CD uniformity in SADP flows, while CD-AFM offers three-dimensional profiling to detect sidewall variations and spacer defects that SEM alone may miss. These tools enable periodic calibration of scatterometry models and inline verification, crucial for controlling pitch walk in self-aligned quadruple patterning (SAQP).[66][67][68] As of 2025, AI-driven defect prediction has emerged as a key mitigation strategy, using machine learning to forecast stochastic failures and process variations in multiple patterning, thereby reducing yield loss by approximately 15% through early intervention. Computational guided inspection frameworks integrate neural networks to analyze multi-layer defect risks, enhancing prediction accuracy for hybrid flows and minimizing inline yield impacts. This approach prioritizes high-risk patterns, allowing proactive adjustments in lithography and etch steps.[69][70] In 3D stacking architectures like complementary field-effect transistors (CFETs), multiple patterning errors are amplified due to the vertical integration of stacked layers, where misalignment in fin or nanosheet patterning propagates through multi-stack etches, exacerbating vertical EPE and dopant segregation. The 3D structure intensifies overlay challenges, as small lateral errors in base patterning layers lead to compounded variability in upper stacks, impacting device performance and reliability in sub-3 nm nodes. Tight control of inner spacers and etch-back uniformity is essential to mitigate these amplified effects.[71][72]Industrial Adoption and Future
Adoption in Logic and Memory Nodes
Multiple patterning techniques have played a pivotal role in enabling the scaling of logic devices to advanced nodes, particularly where extreme ultraviolet (EUV) lithography was not yet fully mature. Intel incorporated self-aligned quadruple patterning (SAQP) to form fins and gates in its 7 nm and 5 nm FinFET processes, allowing for precise control over critical dimensions below 20 nm while maintaining pattern fidelity.[73] Similarly, TSMC applied litho-etch-litho-etch (LELE) double patterning for back-end-of-line (BEOL) interconnects in its 5 nm node, addressing the challenges of dense metal routing without EUV for all layers.[74] These approaches ensured reliable transistor density improvements, with SAQP providing self-alignment to minimize overlay errors in front-end-of-line (FEOL) features. In memory technologies, multiple patterning has been indispensable for high-aspect-ratio structures. For dynamic random-access memory (DRAM) at 1x nm generations (around 14-16 nm half-pitch), spacer-is-dielectric self-aligned double patterning (SID SADP) is employed to pattern capacitor holes, using conformal spacers to define storage node openings with a single mandrel mask and reducing the need for multiple lithographic exposures.[75] In 3D NAND flash, SADP combined with line-cut masks patterns wordlines, enabling the separation of continuous lines into individual cells across stacked layers, which supports terabit-scale densities while managing etch selectivity in vertical channels.[76] At the 7 nm and 5 nm nodes, multiple patterning was required for the majority of layers to achieve sub-20 nm pitches, though the introduction of partial EUV at 3 nm reduced this dependency by single-patterning critical features.[77] Samsung demonstrated functional 7 nm silicon incorporating SAQP for fin patterning as early as 2018, validating the technique's viability for high-performance logic before full EUV integration.[78] This approach was extended to Samsung's 3 nm gate-all-around (GAA) process in 2022, where SAQP supported nanosheet formation in early production ramps.[79] As of 2025, multiple patterning remains integral to nodes like TSMC's N2 (2 nm), applied to non-EUV layers such as peripheral interconnects to complement EUV for core features, ensuring cost-effective scaling amid ongoing EUV throughput limitations. Pilot production of N2 wafers began in 2025, with mass production starting by the end of the year.[80][81]Integration with EUV and Beyond
Multiple patterning techniques continue to play a complementary role in extreme ultraviolet (EUV) lithography ecosystems, particularly as the industry transitions from deep ultraviolet (DUV) dominance to EUV-enabled scaling. Low-numerical-aperture (low-NA) EUV systems, with a numerical aperture (NA) of 0.33, enable single patterning for most critical layers down to approximately 24 nm pitch in logic and memory applications, significantly reducing the complexity compared to DUV multiple patterning. However, for denser features below 20 nm pitch, such as vias and contacts in advanced nodes, low-NA EUV often requires double or quadruple patterning to achieve the necessary resolution and overlay control. High-NA EUV systems, operating at 0.55 NA, further extend single-patterning capabilities to around 20 nm pitch for metal lines and spaces, as demonstrated by imec's achievements in patterning 20 nm pitch damascene structures and 13 nm tip-to-tip spacing without multiple exposures. Despite this progress, high-NA EUV still necessitates double patterning for sub-20 nm pitches in vias and other high-density elements, where stochastic noise limits single-exposure viability.[82][4][83] Hybrid flows integrating EUV and DUV multiple patterning have emerged as practical solutions to optimize cost and throughput in sub-5 nm nodes, leveraging the strengths of each technology. In these schemes, EUV is typically used for patterning cuts, vias, and less dense features where its higher resolution minimizes mask counts, while DUV multiple patterning—often self-aligned quadruple patterning (SAQP)—handles the densest line-and-space arrays, such as metal routing or word lines in memory. This approach reduces overall mask requirements compared to full DUV flows and avoids the higher capital costs of expanding EUV capacity for every layer. For instance, in 5 nm node evaluations, hybrid EUV-DUV processes have shown feasibility for achieving 40 nm pitch gratings with improved edge placement error over pure multiple patterning alternatives.[84][85] Looking beyond 2025, multiple patterning remains integral to 2 nm and 1.4 nm (A16/A14) nodes starting in 2026, particularly for enabling backside power delivery (BSPDN) structures that route power rails through the wafer backside to reduce IR drop and improve performance by 15-20%. In these nodes, EUV multiple patterning will be applied to fabricate high-aspect-ratio vias and trenches for BSPDN, often requiring double patterning even with high-NA tools due to overlay tolerances below 2 nm. TSMC's A16 process, for example, incorporates BSPDN with multiple patterning for critical interconnects, forgoing high-NA EUV in favor of low-NA EUV hybrids to control costs. Challenges in this integration include amplified EUV stochastic defects, where photon shot noise and resist blur in multiple exposures can increase line-edge roughness by 20-30% and defect densities to over 1/cm² at sub-20 nm pitches, necessitating advanced dose controls and simulation-based mitigation.[86][87] As of 2025, regional developments underscore multiple patterning's ongoing relevance amid EUV adoption hurdles. In China, semiconductor manufacturers like SMIC are employing DUV multiple patterning—up to seven exposures per layer—on 28 nm immersion tools to produce 7 nm-equivalent logic chips, achieving yields sufficient for commercial devices despite U.S. export restrictions on EUV. Meanwhile, imec's research on EUV multiple patterning for A10 (sub-1 nm equivalent) nodes demonstrates 18 nm pitch lines/spaces using low-NA EUV double patterning, paving the way for hybrid integration in cost-optimized flows. Samsung began mass production of its 2 nm GAA chips in November 2025, continuing to integrate multiple patterning where needed. Post-3 nm, multiple patterning is expected to decline in high-volume logic due to EUV maturation but persist in cost-sensitive memory applications like DRAM and NAND, where economic pressures favor DUV extensions over full EUV retrofits, potentially sustaining quadruple patterning through the decade.[88][89][90][91]Limits of DUV Multipatterning Extensions
While SAQP and variants like SAOP enable sub-10 nm features in principle, practical application for full logic nodes beyond 7nm/5nm faces severe constraints when relying solely on 193nm DUV immersion lithography. For 5nm-class nodes (metal pitches ~24–32 nm, fin pitches ~18–28 nm), aggressive SAQP or hybrid LELE+SADP/SAQP flows are feasible, often requiring 4–6 masks per critical layer. Chinese manufacturers (e.g., SMIC) have pursued this under EUV export restrictions, with patents and reports indicating quadruple patterning for 5nm-class production, achieving limited yields but at higher costs and complexity compared to EUV flows.[92][93] At 3nm-class (pitches ~20–24 nm), DUV extension is marginal: possible for simple 1D structures via SAQP/SAOP, but 2D routing, vias, and contacts demand extreme decomposition, amplifying cumulative errors. Pitch walking and overlay budgets shrink below 2 nm, leading to yield drops (often below 70–80% for complex layers) and defect increases from stochastic effects. For 2nm-class (sub-20 nm pitches), extreme schemes like self-aligned sextuple (SASP) or octuple (SAOP) become theoretically capable of ~10 nm half-pitch but impractical for high-volume logic: cumulative EPE exceeds tolerances (sub-1 nm needed), defect densities soar, and process steps multiply costs 2–3× over EUV equivalents. Throughput collapses due to dozens of additional modules per wafer, extending cycle times significantly and limiting fab responsiveness.[94] Key collapse factors include:- Overlay and EPE: Each added spacer/exposure risks misalignment; older DUV tools (~1.5 nm overlay) fall short.
- Yield: Multi-step processes introduce particles/defects; historical Intel 10nm multipatterning struggles illustrate risks.[95]
- Cost/Throughput: Mask counts and non-litho steps inflate expenses (litho ~30–50% of wafer cost); effective scanner throughput drops sharply.
